Substratgröße (bis zu) | Ø 150 mm |
Substrathalter | Wassergekühlt, Heliumrückseitenkühlung, Substratrotation 1 bis 20 U/min, kippbar in-situ von 0° bis 165° in 0,1°-Schritten |
Ionenstrahlquelle | 190 mm zirkulare Mikrowellen-ECR-Quelle (MW218-e) |
Neutralisator | Dreifach-Plasma-Brücken-Neutralisator (N‑3DC) |
Basisdruck | < 5 x 10-7 mbar |
Systemabmessungen (L x B x H) | 1,90 m x 1,80 m x 1,75 m (ohne Schaltschrank) |
Konfiguration | Einzelkammer, optionale Einzelsubstratschleuse, optionale OES- oder SIMS-basierte Endpunktkontrolle |
Softwareschnittstellen | SECS II / GEM, OPC |
Vollflächiges Ätzen auf 150 mm Substraten
Die scia Mill 150 wird für die Strukturierung von komplexen Multilagen auf verschiedensten Materialien eingesetzt. Durch die Kompatibilität mit Reaktivgasen ermöglicht das System Ätzprozesse (Ion Beam Milling / Ion Beam Etching) mit erhöhter Selektivität und Rate. Das platzsparende Design macht aus der scia Mill 150 das ideale System für die Kleinserienproduktion und F&E-Anwendungen.
- Einstellbarer Einfallswinkel beim Ätzen durch kippbaren und drehbaren Substrathalter
- Ausgezeichnete Homogenität ohne Shaper
- Erhöhte Selektivität und Rate durch reaktive Gase
- Prozesskontrolle mit exakter SIMS-basierter oder optischer Endpunktdetektion
- Anpassung an verschiedene Substratgrößen mittels Carrier-Konzept
- Bearbeitung von Wafern mit Fotolack aufgrund guter Substratkühlung möglich
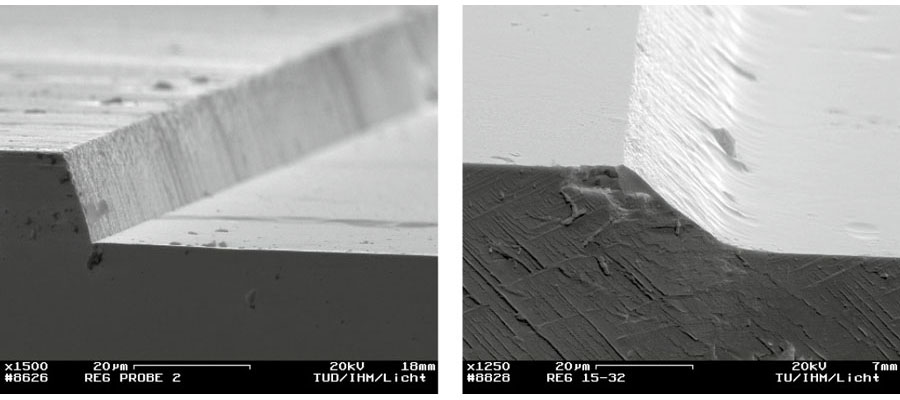
REM-Aufnahme der Ätzkante mit freundlicher Genehmigung der DIAS Infrared GmbH.
Ätzen von 15 µm Lithiumtantalat mit Fotolack für einen pyroelektrischen Sensor mit 15°-Einfallswinkel. Links: Standard-Fotolackmaske mit scharfen Kanten. Rechts: Optimierter Fotolack mit glatten Kanten und verbesserter elektrischer Verbindung mit dem Sensor.
- Strukturierung von Magnetspeichern (MRAM) und Sensoren (IR, GMR, TMR)
- Ätzen von Metallen in der Produktion von MEMS (Au, Ru, Ta, …)
- Ätzen von Multilagen verschiedener Metalle und dielektrischer Materialien
- Chemisch-unterstütztes Ionenstrahlätzen (Chemically Assisted Ion Beam Etching, CAIBE) von Verbindungshalbleitern (GaAs, GaN, InP, …)
- Produktion von 3D-optoelektronischen Mikrostrukturen
- Ionenstrahlglätten zur Reduzierung von Mikrorauheit
- Reaktives Ionenstrahlätzen (Reactive Ion Beam Etching, RIBE) zur Musterübertragung für optische Gitter (SiO2)
Application Notes
- Optische Gitter für AR und MR-Geräte
- Magnetische Multilagen für Sensoren mit TMR-Effekt
- Herstellung von Lithiumtantalat für Infrarot-Sensoren (IR)
- Reverse Engineering von IC-Chip-Bauteilen
- Zirkulare Ionenstrahlquelle ätzt mit inerten oder reaktiven Gasen über die volle Substratfläche unter einem definierten Winkel
Technologien
Ionenstrahlätzen (IBE/IBM)
Ein gebündelter Strahl aus Inertgas-Ionen wird auf ein Substrat gerichtet. Durch den Ionenbeschuss wird das Substrat strukturiert oder Material abgetragen.
Reaktives Ionenstrahlätzen (RIBE)
Reaktives Ätzen des Substrats durch die Einleitung von Reaktivgasen in die Ionenstrahlquelle.
Chemisch-unterstütztes Ionenstrahlätzen (CAIBE)
Reaktivgase werden unabhängig vom Ionenstrahl nahe des Substrats eingebracht.
PDF Download
Product Flyer scia Mill 150
Interessiert?
Wir beraten Sie gerne!
Kontaktieren Sie uns.
Produktübersicht
Laden Sie unsere Broschüre als PDF herunter.